
苹果发布了昨天凌晨苹果春季发布会上最强的 “M1 Ultra”芯片。
芯片采购网专注于整合国内外授权IC代理商现货资源,芯片库存实时查询,行业价格合理,采购方便IC芯片,国内专业芯片采购平台。
苹果在会议上宣布 M1 Ultra 芯片中有许多强大的参数,如1140亿颗晶体管;20核CPU(16 高性能内核和 4 高效内核);最高64核GPU;32核神经网络引擎;2.5TB/s数据传输速率8000GB/s内存带宽最高128GB统一内存。

M1 Ultra 是 Apple 芯片的另一个游戏规则变化者将再次震惊 PC 行业。通过两个M1 Max 芯片和我们的 UltraFusion 我们可以连接封装结构 Apple 芯片扩展到前所未有的新高度。
苹果的硬件技术Espressif代理高级副总裁Johny Srouji表示:凭借它的力量CPU、庞大的 GPU、神经引擎令人难以置信,ProRes 硬件加速和大量统一内存,M1 Ultra 完善了M成为世界上最强大、最强大的个人计算机芯片。
苹果的Ultra Fushion架构众所周知,要制造更强大的芯片,你需要堆积更多的电路和晶体管。工艺越先进,同一区域的晶体管越多,芯片性能上限越高,这也是人们追求更先进工艺的原因之一。
然而,在目前的工艺和技术条件下,如果晶体管较多,良率将降低,良率将降低,每个芯片将变得非常昂贵。那么,如何在降低成本的前提下制造超越极限的芯片呢?
采用苹果的做法M1 Max通过隐藏在中间的芯片互连模块UltraFushion架构将两块芯片像拼图一样合二为一。
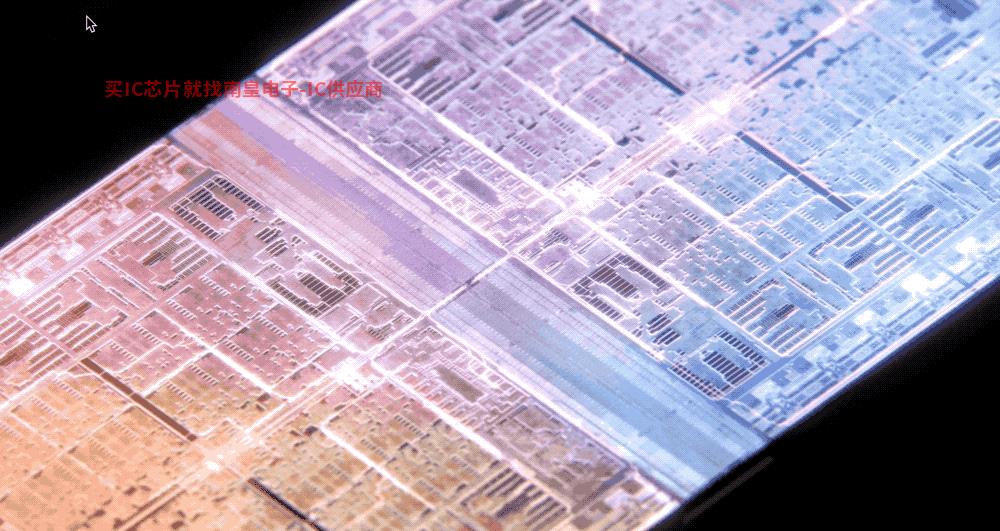
苹果的“UltraFushion”其实就是Die to Die Connection,在芯片设计中,同一包装(package)使用多个硅片(silicon),而且设计了极其高速的互联通道,使这两个硅片能够像同一个芯片一样工作。
UltraFusion使用了1万条DTD高达2的连接.5TB/s它的互联速度极高,能耗极低,因为它是几块die联合包装对良率的敏感性远低于超巨型芯片,因此DTD也被认为是未来芯片性能发展潜力巨大的道路。
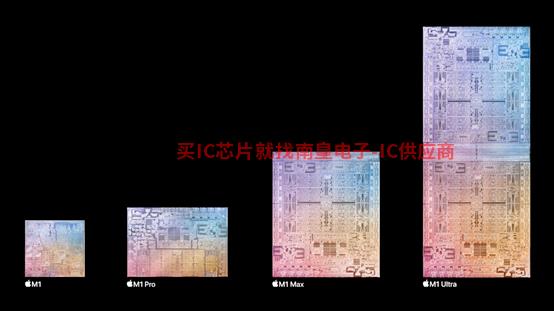
值得一提的是,M1 Max以小芯片为基础(Chiplet)在设计中,芯片模块堆叠多个芯片(MCM),其2-tile使其从规格CPU到GPU到NPU从内存带宽到内存容量,都是2xM1 Max的规格。
与华为的芯片叠加专利理念一致当然,苹果不是唯一一条路,AMD 早在 2017 年就引入了MCM 并且在 2019 年引入了Chiplet 设计,未来的发展趋势是进一步提高堆叠能力,实现所谓的 3D 堆叠,也就是说,不仅仅是 2D 向上扩展,也要向垂直方向扩展。

华为海思在国内企业也有同样的想法。2021年5月,华为公开了双芯叠加专利,并表示14nm技术可达7nm这个消息一出来,就在全世界引起了热议,引起了全世界的关注。简单来讲14nm与7nm它们之间的主要区别是芯片面积相同,7nm晶体管数量可以增加,性能自然会提高。
高性能产品Chiplet这条路走得通知乎用户@超合金彩虹糖表示这颗M1Ultra这是苹果野心的进一步延续,甚至是最富有的苹果也转向了Chiplet因此,这表明高性能产品可能会在未来的消费领域走向Chiplet这条路可以走得通。目前,芯片组合叠加已从理论转变为现实。从芯片包装的角度来看,从2开始.5D封装走向3D封装,芯粒(Chiplet) 提供最佳性能和最大灵活性。台积电,英特尔,三星,AMD十家公司已经采取行动,共同成立UCIe联盟。(详情:英特尔,AMD、Arm等九大企业宣布UCle开放标准,促进Chiplet发展)
UCIe联盟的初衷是将小芯片打造成开放互联的产业发展生态,让不同的客户通过各种小芯片产品满足更多的需求。
未来,以Chiplet集成模式的芯片将是一个超级异构系统,可以带来更多的灵活性和新的机会。
芯原股份有限公司创始人、董事长兼总裁戴伟民曾表示,对于行业而言,Chiplet在标准和生态层面上,Chiplet建立了新的可互操作组件、互联协议和软件生态系统;为芯片制造和包装增加了多芯片模块 (Multi-Chip Module,MCM) 业务,Chiplet迭代周期远低于ASIC,可提高晶圆厂和封装厂的生产线利用率;半导体IP升级为Chiplet供应商,可以提升IP最后,对于芯片设计,降低了大规模芯片设计的门槛。
戴伟民建议国内企业继续推进Chiplet量产和2.5D/3D开发封测技术。
- 疯泰国投资 台PCB厂抢跟进
- AMD Zen4锐龙7000全线曝光:16核心5.7GHz一飞冲天!
- 高通:与台积电、三星两大晶圆厂保持先进工艺合作战略
- VIAVI最新报告:2021年新增635座部署5G的城市,5G覆盖全球1947个城市
- BOE(京东方)2022年一季报:营收超500亿元 高质量发展稳中求进
- 三星计划在德州投资2000亿美元建立11家芯片厂
- Google的开源PDK里面有什么?尝试这样的新鲜版!
- BaaS中国区块链市场规模不断突破,市场格局再次发生变化BaaS2021年发布市场份额
- 瑞萨电子推出复合驱动软件,加快电动汽车电池管理系统的发展
- 朗科RGB DDR4,频率4266MHz!国内内存的新高度
- Inuitive 与 Arteris IP 边缘设备合作 提供下一代视觉处理技术
- 施耐德电机新一代电机启动器 创造可持续、安全的客户体验






















